
-
HDI Micro vias PCB
HDI Micro vias LEITERPLATTEN
Warum Blind Via HDI LEITERPLATTEN
Microvias und gestapelte Microvias finden sich in High-Density-Interconnect-Leiterplatten, auch bekannt als HDI-Leiterplatten, um komplexe Verbindungen in modernen Designs zu ermöglichen.
Microvias, gestapelte Microvias und Via-in-Pad-Merkmale ermöglichen eine Miniaturisierung für höhere Funktionalität auf kleinerem Raum und können Chips mit großer Pin-Anzahl aufnehmen, wie sie in Handys und Tablets verwendet werden. Microvias tragen dazu bei, die Anzahl der Lagen in Leiterplattendesigns zu reduzieren, während sie eine höhere Routingdichte ermöglichen und Durchkontaktierungen überflüssig machen.
Die steigende Nachfrage der Verbraucher nach mehr Funktionen in ihren kleinen und mobilen Elektronikprodukten wie PDAs und Mobiltelefonen führt zu einem Bedarf an kleineren Funktionsgrößen, Prozessgeometrien und Leiterplatten. Für Ingenieure, die sich mit diesen Wünschen befassen, ist der Bedarf an HDI (High-Density-Interconnect)-Technologie eine Realität geworden. HemeixinLEITERPLATTEN beschreibt die HDI-Leiterplattentechnologie als einen Prozess, der es ermöglicht, eine Leiterplatte mit Durchgangslöchern, Sacklöchern oder vergrabenen Durchkontaktierungen mit einem Durchmesser von weniger als 0,006 Zoll zu produzieren, ohne die herkömmliche Bohrtechnik zu verwenden. Anwender der HDI-Technologie müssen nicht nur in der Lage sein, die Technologie der nächsten Generation einzuschätzen und zu implementieren, sondern auch ihre Grenzen in Bezug auf den Lagenaufbau, die Bildung von Durchkontaktierungen und Microvias, die Größe der Merkmale und die wichtigsten Unterschiede zu herkömmlichen Leiterplattentechnologien zu verstehen.
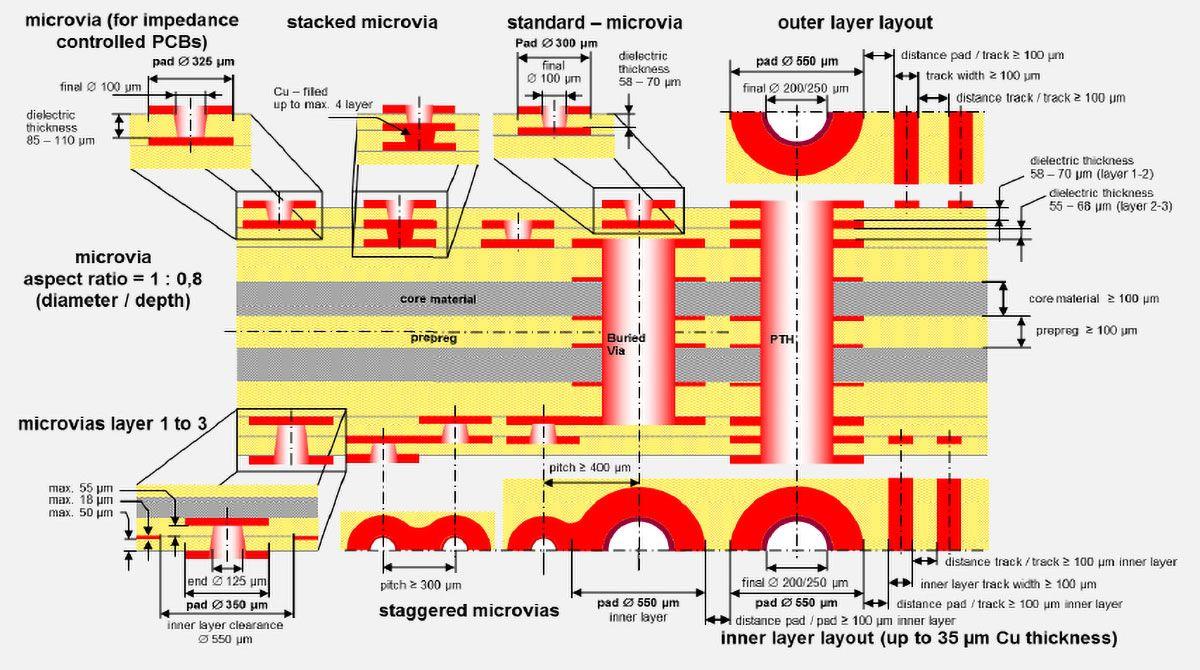
Blind Via und Buried Via
Wenn der Platz auf der Leiterplatte begrenzt ist oder Sie mit engen Durchkontaktierungen arbeiten müssen, können Blind- und vergrabene Durchkontaktierungen die Lösung sein.
Die Blind & Buried Via-Technologie hat eine entscheidende Rolle dabei gespielt, mehr Leistung auf kleinerem Raum zu erreichen. Durch die Verkürzung von Durchkontaktierungen, die nur durch die notwendigen Schichten führen, wird mehr Fläche für Komponenten verfügbar.
Blind Vias und vergrabene Vias werden zur Verbindung zwischen den Lagen einer Leiterplatte verwendet, wenn der Platz knapp ist. Ein Blind Via verbindet eine Außenlage mit einer oder mehreren Innenlagen, geht aber nicht durch die gesamte Leiterplatte. Ein Buried Via verbindet zwei oder mehr innere Lagen, geht aber nicht durch eine äußere Lage.
Die wichtigsten Vorteile sind:
- Fähigkeit, die Dichtevorgaben für Leitungen und Pads in einem typischen Design zu erfüllen, ohne die Anzahl der Lagen oder die Größe der Leiterplatte zu erhöhen
- Verringerung des Seitenverhältnisses von Leiterplatten
Ein Blind Via ist ein kupferbeschichtetes Loch, das nur eine Außenschicht mit einer oder mehreren Innenschichten verbindet. Ein Blind Via geht nie ganz durch eine Leiterplatte hindurch. In Bezug auf das Design werden Blind Vias in einer separaten Bohrdatei definiert.
Zusätzlicher Nutzen von Blind Vias:
Möglichkeit, den BGA-Breakout-Kanal zu verbreitern (Reduzierung der Lagenzahl)
Ein vergrabenes Via ist ein kupferbeschichtetes Loch, das zwei oder mehr innere Lagen miteinander verbindet und keinen Kontakt zur äußeren Lage hat. Es ist unmöglich, ein vergrabenes Via zu erkennen, da es unter den äußeren Lagen einer Leiterplatte "begraben" ist. Vergrabene Durchkontaktierungen erfordern auch eine separate Bohrdatei.Buried Via
Zusätzliche Vorteile von vergrabenen Durchführungen
- Keine Beeinträchtigung von Leiterbahnen oder oberflächenmontierten Bauteilen auf den oberen oder unteren Lagen der Leiterplatte.
- Leiterbahn- oder SMD-Pad-Platzierung auf den äußeren Lagen direkt über dem vergrabenen Via (zusätzlicher Platz auf den äußeren Lagen)
Was ist ein Microvia-Loch?
Nach der neuen Definition in IPC-T-50M ist eine Microvia eine Blindstruktur mit einem maximalen Seitenverhältnis von 1:1, die auf einer Zielfläche mit einer Gesamttiefe von nicht mehr als 0,25 mm, gemessen von der Fangfläche der Struktur bis zur Zielfläche, endet.
Die IPC-6012 definiert auch die Struktur eines Microvia.
- Die Microvia ist eine Blindstruktur mit einem maximalen Seitenverhältnis von 1:1 zwischen Lochdurchmesser und -tiefe und einer Gesamttiefe von nicht mehr als 0,25 mm, gemessen von der Oberfläche bis zur Zielfläche oder -ebene.
- Normalerweise geht Hemeixin von einer dielektrischen Dicke zwischen Oberfläche und Referenzpad von 60 - 80 um aus.
- Der Durchmesser der Microvia liegt zwischen 80 und 100 Mikrometern. Das typische RATIO liegt zwischen 0,6: 1 und 1: 1, ideal 0,8: 1
Der Schichtenaufbau ist ein wesentliches Unterscheidungsmerkmal der HDI-Aufbautechnologie. Ingenieure stellen einen HDI-Schichtaufbau her, indem sie zusätzliche Microvia-Schichten auf herkömmliche Leiterplattenkerne aufbringen. Die Industrie verwendet HDI-Aufbautypen, um die verfügbaren Schichtaufbauten zu beschreiben. Derzeit sind drei gängige HDI-Aufbauarten im Einsatz (siehe Bild unten). Typ I umfasst einen herkömmlichen starren oder flexiblen Leiterplattenkern mit einer beliebigen Anzahl von Lagen unter Verwendung von Durchgangslöchern und einer einzelnen Microvia-Lage, die auf einer oder beiden Seiten des Kerns hergestellt wird. Der Aufbau des Typs II ist ähnlich, jedoch werden die Durchkontaktierungen im Kern hergestellt, bevor die Microvia-Schichten hinzugefügt werden. Typ III hat mindestens zwei Microvia-Schichten auf mindestens einer der Kernoberflächen.

Es sind mehrere andere Konstruktionsarten erhältlich. Typ IV umfasst einen "passiven" Kern, der als nicht-elektrische Abschirmung oder als Wärmepuffer fungieren kann. Die "kernlose" Konstruktion, die aus zwei zusammenlaminierten Substraten besteht, ist Typ V. Beim Typ VI, der auch als Kolaminierung bezeichnet wird, werden die Verbindungselemente und die mechanische Struktur gleichzeitig hergestellt.
Die Vielzahl der Lagen, die Ingenieure durch die Kombination von HDI-Konstruktionstypen und einer unterschiedlichen Anzahl von Lagen erzeugen können, hat dazu geführt, dass ein einfaches Bezeichnungsschema erforderlich ist, um sie zu identifizieren. Die Bezeichnungsmethode ist einfach. Die Bezeichnung "2 (C4) 2" weist beispielsweise auf einen Lagenaufbau hin, der einen vierlagigen Leiterplattenkern (C4) mit zwei HDI-Lagen (Aufbau) auf der Oberseite und zwei auf der Unterseite umfasst. Die Bezeichnung "2 (P) 2" weist auf einen Typ IV-Aufbau mit einem passiven Kern, zwei HDI-Schichten auf der Oberseite und zwei HDI-Schichten auf der Unterseite hin.
Microvia und ihre Auswirkungen auf HDI-Leiterplatten
Ein Microvia wird geformt, nicht gebohrt wie ein herkömmliches Via. Ingenieure verwenden derzeit mehrere Verfahren zur Herstellung von Microvias. Beim Laserbohren, dem gebräuchlichsten Verfahren, wird ein fokussierter Laserstrahl verwendet, um das Loch zu formen. Beim Nass-/Trockenätzen handelt es sich um ein Massenproduktionsverfahren, bei dem alle Durchkontaktierungen gleichzeitig hergestellt werden, unabhängig von der Anzahl oder dem Durchmesser der Löcher. Beim Photo-Imaging wird das Basissubstrat mit einer dielektrischen Schicht überzogen. Ingenieure können auch leitfähige Tinte in Microvia Bildung verwenden. In einem solchen Prozess werden die Microvias durch Laserbohren, Photo-Imaging oder Isolationsverschiebung geformt. Sie können Microvias auch mechanisch durch Durchstechen, Stanzen, Strahlen oder einfaches Bohren erzeugen. Bei jedem Verfahren entstehen unterschiedliche Formen von Microvias, z. B. Becher, positive und negative Verjüngungen und gerade Wände (siehe Abbildung unten).
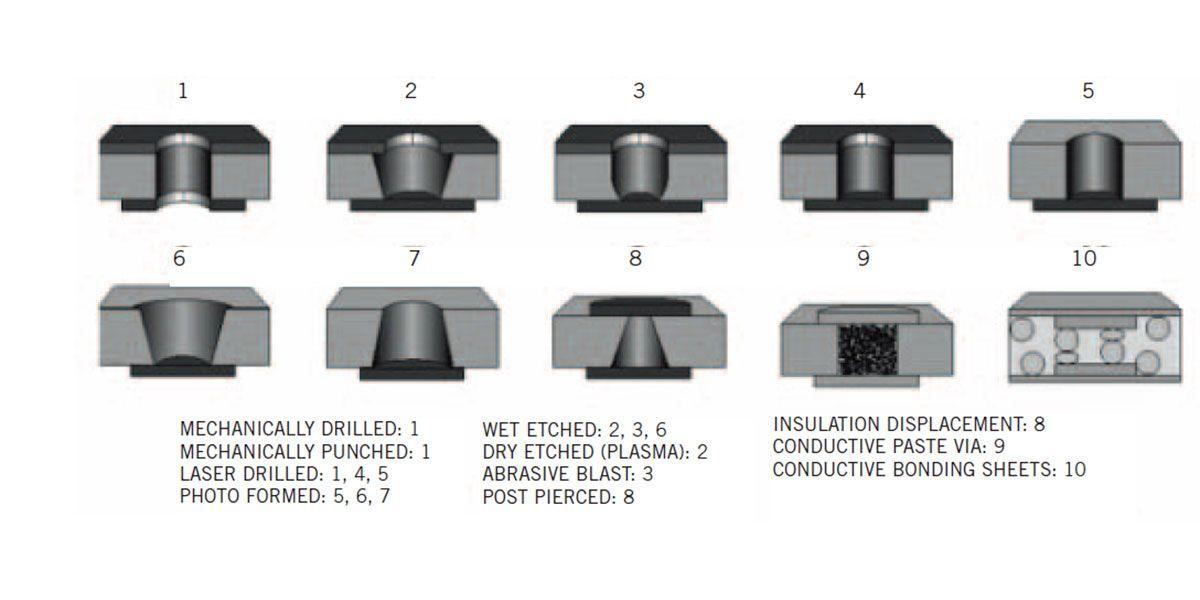
Jedes Microvia-Herstellungsverfahren erzeugt eine andere Lochform.
Das Aufkommen der HDI-Technologie und der Microvias hat auch zu einem neuen Vokabular für Via-Strukturen geführt. Das HDI Design Subcommittee des IPC definiert Microvias als "formed blind and buried vias", die weniger als oder gleich 0,15 mm messen und einen Pad-Durchmesser von weniger als oder gleich 0,35 mm haben. Darüber hinaus verwenden Designer Begriffe wie "Capture Land" (der Bereich, in dem die Microvia ihren Ursprung hat) und "Target Land" (der Bereich, in dem die Microvia endet), um die Größe der Microvia-Pads zu beschreiben. Ein landloses Via hat einen Stegdurchmesser, der gleich groß oder kleiner als der Via-Durchmesser ist.
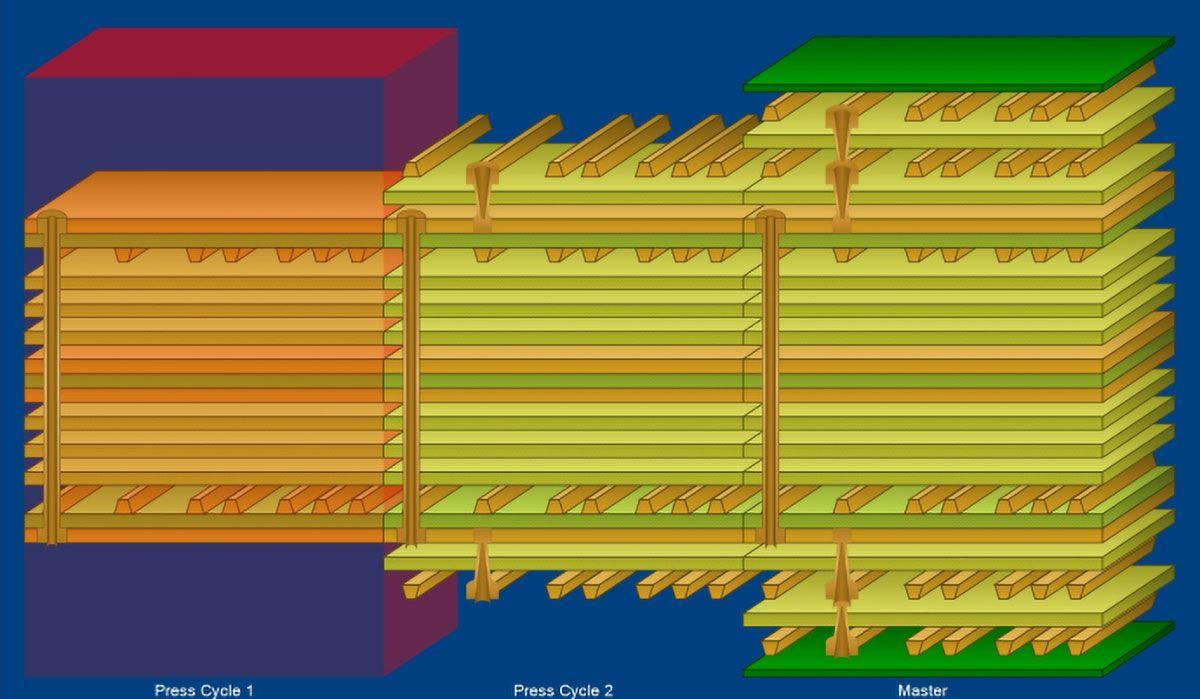
Derzeit ist die Strombelastbarkeit von Microvias aufgrund ihrer Größe begrenzt. Designer überwinden diese Einschränkung in der Regel, indem sie mehrere Microvias in einem großen Bereich, einem so genannten Plural Via, verschachteln. Microvias, die nicht benachbarte HDI-Aufbaulagen direkt miteinander verbinden, werden als Skip Vias bezeichnet. Ein Microvia mit variabler Tiefe ist ein in einem Arbeitsgang hergestelltes Microvia, das zwei oder mehr HDI-Dielektrikumsschichten durchdringt und an einer oder mehreren Schichten endet. Laser-Vias, konforme Vias, gefüllte Vias, Foto-Vias und Bolzen-Vias sind Mikrovias, die ihre Namen von den zu ihrer Herstellung verwendeten Verfahren ableiten.
Jeder HDI-Leiterplattentyp erlaubt die Verwendung unterschiedlicher Kombinationen von "Standard"-Durchkontaktierungen und Microvia-Strukturen. Bei der Bauart I können Sie blinde, einlagige Microvias und ein Standard-Durchkontaktierungsloch verwenden. Das Standard-Via erstreckt sich über alle Lagen im Stapel, einschließlich der HDI-Aufbaulagen. Typ II ähnelt dem Typ I, fügt aber ein vergrabenes Via hinzu, das sich über alle Schichten des Leiterplattenkerns erstreckt. Typ III erhöht die Komplexität der Via-Strukturen noch weiter und ermöglicht die Verwendung von vergrabenen, gestapelten, versetzten und unterschiedlich tiefen Mikrovias. Diese vielen Via-Strukturen können das Layout von HDI-Buildup-Designs erheblich verkomplizieren.
- Home
- Technologie
- hochdichte Leiterplatten
- LeiterplattenTechnologie
- Leiterplatten Material
- Via-in-Pad
- Dickkupfer Leiterplatten
- Hochdichte Leiterplatten
- Impedanzkontrollierte Leiterplatten
- Hochfrequenz Leiterplatten
- Starrflex Leiterplatten
- Flexiblen Leiterplatten Biegen und Falten
- Aluminium Leiterplatte
- Designrichtlinien für Flex Leiterplatten
- Designrichtlinien für Starrflex Leiterplatten
- Designrichtlinien für HDI Leiterplatten
- Designrichtlinien für Dickkupfer Leiterplatten
- Fragen zum Flex LeiterplattenDesign
- Fragen zum Starrflex LeiterplattenDesign
- Fragen zum leiterplattenbestückung Design
-
Phone:
-
Email:Diese E-Mail-Adresse ist vor Spambots geschützt! Zur Anzeige muss JavaScript eingeschaltet sein!




